2013. 7. 11. 09:49ㆍ과학 이야기
주사탐침 현미경(SPM)의 원리와 응용
저자: 홍재완 박사 / ㈜나노포커스 대표
출처: [나노세계를 여는 창], 코셈 매거진
1. 개요
주사탐침 현미경(Scanning Probe Microscope)은 원자, 분자 수준의 분해능을 갖는 표면 계측 장비로서 나노 특성 분석에 널리 활용되고 있으며 나노기술 발전에 큰 기여를 해 왔다. SPM은 캔틸레버에 달린 나노 크기의 예리한 바늘이 시료 표면을 근접 비행할 때 시료와 탐침 사이에 상호작용하는 물리량을 측정하는 장치 일체를 통칭한다. 시료로부터 먼 거리에서 신호를 검출하는(far-field detection) 방식인 광학, 전자현미경과 달리 SPM은 탐침과 시료 사이의 원자력, 터널링 전류, 전자기력 등의 근접장을 검출하는 근접 탐침 기술이다. SPM은 나노 수준으로 예리한 바늘이 달림 탐침을 시료에 근접시켰을 때 바늘 끝이 느끼는 근접장 상호 작용을 이용하여 표면 형상 뿐만 아니라 다양한 물리적 특성을 검출하는 장치이다. 따라서 해상도는 탐침 첨단의 크기, 근접 거리 및 상호작용의 거리 의존도에 지배되기 때문에 수평 분해능은 0.1 nm 정도이며, 수직 분해능은 0.01 nm 정도로 개별 원자 분자를 구별할 수 있는 수준이다.
또한 SPM 탐침의 기능과 특성에 따라 3차원 형상, 전자기 특성, 기계적 특성, 광학적 특성 측정 등 다양한 분석에 활용되고 있다. 특히 현존하는 장비 중에서 높이에 대한 정보를 가장 정밀하고 정량적으로 측정할 수 있는 장치이다. 뿐만 아니라 액체 속에서도 동작이 가능하며, 개별 분자 간의 미세 화학적 결합력, 단백 분자의 펼침 힘, 항원 항체 반응 측정이 가능하여 바이오 분야의 물성 평가 도구로서 높은 잠재력을 지니고 있다. SPM이 타 현미경과 구별되는 특징은 미세 탐침으로 나노 세계를 능동적으로 조작할 수 있는 능력을 지녔다는 것이다. SPM은 단순히 나노 세계를 관찰하는 현미경의 기능을 넘어 나노 구조물을 조작하고 제작하는 기능, 다양한 물리적 특성을 분석하는 기능을 지닌 종합적인 나노 계측 분석 장치로 발전하고 있다.
2. SPM의 원리 및 응용
SPM 장치에서 탐침, 상호 작용력 검출을 위한 광학 기계부, 3차원 나노 스케너, 디지털 전자제어 장치, 소프트웨어로 구성되어 있다. 그림 1은 SPM 장치의 구성요소와 개요도를 나타낸다. 일반적으로 SPM 탐침은 예리한 끝을 가진 나노 바늘이 느끼는 미세한 상호작용을 증폭하고 거시적인 세계로 전달하는 막대 스프링(cantilever)으로 구성되어있다. 통상의 SPM 탐침은 마이크로 머시닝으로 제작되며, 캔틸레버는 크기는 길이 100㎛, 폭 10㎛, 두께 1㎛ 정도이며, 캔틸레버 끝에 부착된 바늘은 높이 10㎛, 첨단의 직경 10nm 정도이며 분해능과 응용 분야에 따라 다양한 탐침이 개발되었다.
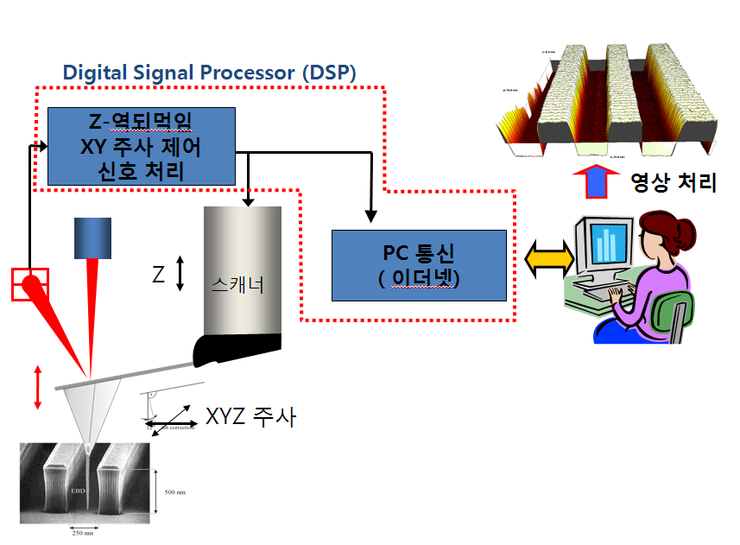
<그림 1> SPM 장치 개요도
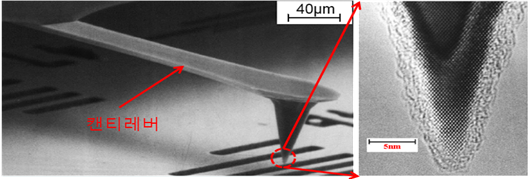
<그림 2> SPM 탐침
AFM(Atomic Force Microscope)은 3차원 형상을 측정 기능을 수행하는 장치로 모든 SPM 측정 기술의 기본이 되는 장치이다. AFM은 탐침 끝의 원자와 시료 표면의 원자들 사이에 작용하는 척력과 van der waals 인력를 이용하며, 작동에 사용되는 힘의 종류에 따라 접촉 모드와 비접촉 모드로 나누어 진다. 시료 표면의 원자와 캔틸레버 끝에 달린 바늘 사이의 원자력은 캔틸레버를 아래 위로 휘게하고, 캔틸레버의 각도변위는 캔틸레버 윗면에서 반사되는 레이저 광선의 각도 편향시킨다. 따라서 레이저 빔의 편향 각도를 포토다이오드(PSPD)로 측정함으로써 표면의 굴곡을 알아내는 것이 AFM의 기본원리이다.
AFM 동작 중에 탐침의 마모를 최소화하고 데이터의 신뢰성, 재현성, 정량적 형상 정보 획득을 위해 역되먹임 제어가 필요하다. 여기서 역되먹임 제어는 탐침이 시료를 XY 방향으로 주사하는 동안 탐침과 시료 사이의 힘 또는 거리를 일정하게 유지하도록 시료나 탐침을 Z축 방향으로 구동하는 동작을 말한다. 탐침이 주사하는 동안 각각의 XY 위치에서 Z축에 역되먹임 되는 전압은 시료의 굴곡 정보에 대응된다. 대부분 상용 AFM의 역되먹임 제어는 디지털 신호처리기(DSP)에 의해 디지털 제어 알고리즘에 의해 처리된다. SPM에 사용되는 XYZ 스캐너는 압전세라믹을 주로 사용하며, 압전 세라믹은 원자수준에서 수백 마이크로미터 영역을 주사할 수 있으며 원자수준의 정밀도를 제공한다. 압전 세라믹은 전기적 신호를 변위로 변환하는 장치로 정밀도가 높고, 소형화, 고속 응답이 가능하여 오늘날 나노 기술 분야에서 널리 활용되고 있다. 하지만 압전 구동기는 비선형성, 이력, Creep 현상으로 인하여 영상의 왜곡을 발생시킬 뿐만 아니라 데이터의 정확도와 신뢰도에도 영향을 준다. 이러한 문제를 해결하기 위해 일반적으로 스캐너의 부착한 정밀 위치 센서와 제어 알고리즘을 통하여 비선형 오차, 이력, 드리프트를 실시간으로 제어하고 보정할 수 있는 Closed-loop XY 주사 기술을 사용한다.
2-1. 접촉모드(Contact mode)
탐침과 시료 사이의 척력을 이용하는 스캔하는 방법으로, 상대적으로 작동법이 쉬우며, 시료가 단단한 경우에 주로 사용하는 방법이다. 탐침과 시료가 접촉하였을 때 탐침이나 시료가 받는 수직 힘은 후크의 법칙을 따른다(F=-kz). 여기서 k는 캔틸레버의 스프링 상수이며, z는 탐침 끝의 위치에서 캔틸레버 변위이다. 역되먹임 루프는 탐침의 구부러지는 각도를 일정하게 유지하도록 탐침과 시료 사이의 거리를 제어한다. 이때 탐침을 수직방향으로 움직이기 역되먹임 제어기의 출력이 시료의 높낮이 정보가 된다. 또한 탐침이 수평방향으로 움직일 때 캔틸레버는 수평방향의 비틀림이 발생할 수 있다. 이러한 횡력은 표면의 분포된 물질의 마찰 특성에 민감하기 때문에 이를 통해 혼합물질의 분포를 알 수 있다. 이처럼 탐침의 횡방향 변위를 측정하는 기법을 LFM(Lateral Force Microscopy)이라 한다. 일반적으로 접촉모드에서 사용되는 탐침의 힘 상수는 가능한 낮은(k<1 N/m) 것을 사용하여 시료와 탐침의 손상을 최소화 한다. 하지만 비접촉모드에 비해 응답속도가 빨라서 고속측정이나 고해상 원자상을 얻는데 주로 활용된다. 접촉모드를 기반으로 하는 대표적인 응용은 LFM, 전기적 특성을 재는 C-AFM(conductive AFM), Nano indentation/scratching과 같은 나노 리쏘그라피 기술 등에 활용된다.
2-2. 비접촉 모드(Noncontact mode)
비접촉 모드는 미약한 원자력을 검출하기 위해 탐침의 동력학적인 진동 특성을 이용하는 AM(Amplitude Modulation) 또는 FM(Frequency Modulation) 기술을 사용한다. 캔틸레버는 공기 중에서도 Q값이 매우 높기 때문에(약 300), 고유 공진 주파수 근처에서는 진동시킬 때 진동의 진폭과 위상이 외부교란에 대해 매우 민감하게 변화한다. 따라서 캔틸레버를 공진 주파수로 수 nm~수십 nm 정도로 진동할 경우 미약한 원자력 변화에도 검출 가능한 정도의 진폭 및 위상 변화가 발생한다. 탐침과 시료의 상호작용에 의한 진폭과 위상 변화는 록인 증폭기에 의해서 직류로 변환된다. 진폭은 탐침과 시료 간 거리에 거의 선형적으로 변하기 때문에 탐침과 시료 사이의 거리를 조절하는데 사용될 수 있다. 비접촉 모드에서 역되먹임 제어기 탐침의 진동 진폭을 일정하게 유지하도록 Z축 스캐너를 상하로 움직인다. 이때 Z축 스캐너에 인가되는 전압은 시료의 실제 높이에 해당된다. 비접촉 모드 동작시 탐침이 시료에 가하는 수직력과 횡력을 거의 무시할 정도이므로 부드러운 시료나 결합력 약한 표면, 높은 3차원 종횡비를 갖는 구조에 대한 영상을 취득할 때 매우 유용한 방법이다. 또한 이 모드에서는 탐침의 마모를 최소화 할 수 있어 접촉모드 보다 데이터의 재현성 및 신뢰도가 높다. 하지만 접촉모드에 비해 속도가 느리며, 제어 파라미터 조절이 까다로운 것이 단점이다.
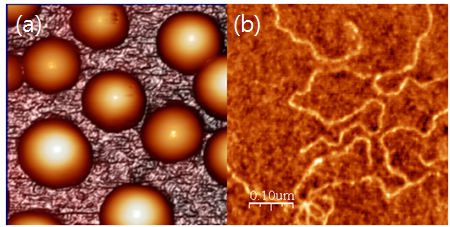
<그림 3> 비접촉 모드 AFM 영상 (a) 50 nm 금 입자 영상 (b) 1nm DNA 영상
3. SPM의 응용
3-1. MFM
MFM(Magnetic Force Microscopy)은 시료의 자기적 특성을 나노 스케일로 측정할 수 있는 현미경 기술이다. AFM 탐침의 바늘 끝에 자성을 띤 물질(Co, Ni)을 코팅하고 수직 방향으로 자화시켜면 미세 자석을 가진 MFM 탐침이 된다. MFM 탐침에서 발생하는 자기장과 자성 시료에서 발생하는 자기장의 쌍극자 상호작용력을 통하여 표면의 자기 정보를 측정할 수 있다. MFM 탐침은 자성과 형상 정보가 혼합된 힘을 느낀다. 따라서 형상과 자성 정보를 구별해내기 위한 기술이 필요하다. 원자간 상호작용력은 탐침과 시료 사이의 거리가 수 nm 정도의 근거리에서만 발생하며 10nm 이상으로 멀어지면 급격하게 줄어든다. 반면 자기력은 수 ㎛ 정도의 원거리까지도 영향을 미치는 원거리 작용력이다. 따라서 근거리 동작에서는 원자력이 자기력보다 휠씬 우세하기 때문에 형상을 측정하고, 10nm 이상의 거리에서는 자기력이 우세하기 때문에 자기력을 측정하는 분리 측정 방식을 사용한다. 이러한 분리 측정 기법을 Lift-mode(또는 two-pass mode)라고 부른다. Lift mode는 두 번의 라인 주사를 통해서 수행된다. 첫번째 주사에서는 탐침을 매우 근접시켜 원자력을 측정하여 표면 형상을 얻고, 첫번째 주사에서 얻은 높이 정보에 일정한 값의 높이를 더하여 (일반적으로 수십 nm 정도) 두번째 주사를 수행한다. 두번째 주사에서 탐침을 원자력은 미치지 않는 높이로 띄우기 때문에 순수한 자기력만 검출할 수 있다. 순수한 자기 정보는 두번째 라인을 주사할 때 캔틸레버의 공진 변화을 이용함으로써 얻을 수 있다. 캔틸레버의 공진 주파수 변화는 진동하는 캔틸레버의 진폭과 위상을 변화시키기 때문에 탐침의 진동 진폭이나 위상 신호는 순수한 자기에 해당된다.
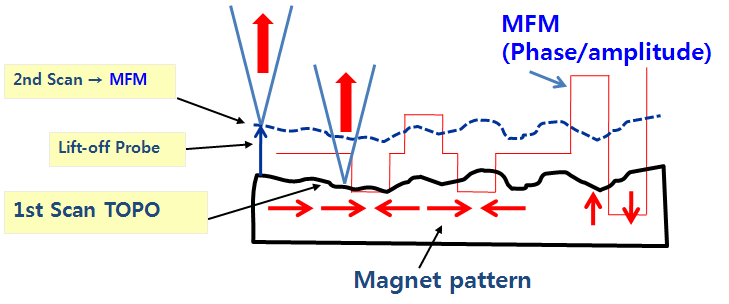
<그림 4> MFM 동작의 개념도 (Lift mode 동작 원리)
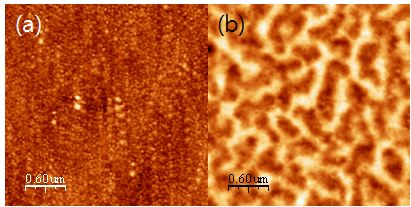
<그림 5> 강자성 박막(LSMO)의 형상 (a) 및 MFM (b) 영상
MFM은 차세대 메모리 소자인 MRAM과 스핀트로닉스 소자 등 비휘발성 자기 메모리나 고밀도 하드디스크 저장 장치 분야에서 활용되고 있으며, 특히 나노스케일 구조 및 자성체의 분극의 성질을 분석하는데 매우 중요한 기술로 평가되고 있다.
3-2. EFM
금속으로 코팅된 탐침과 시료 사이에 전압을 가하면 탐침은 정전기력을 느끼게 되며, 이러한 정전기력을 측정하는 모드를 EFM(Electrostatic Force Microscope)이라 한다. EFM은 시료의 전기적 특성인 표면 전하, 전위, 반도체의 불순물 농도, pn 접합의 전위 분포, 정전 용량 등의 분포를 잴 수 있는 현미경이다. 금속 탐침과 시료 사이에 직류(Vdc) 및 교류(Vac) 전압을 가할 때 탐침과 시료 사이의 정전 용량 결합에 의한 정전기력을 세기는(Fe) 다음과 같이 주어진다.
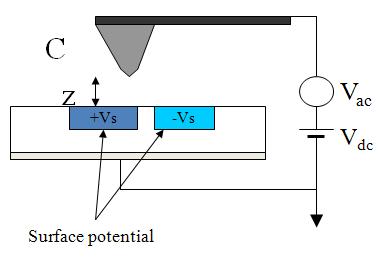
<그림 6> EFM 개념도
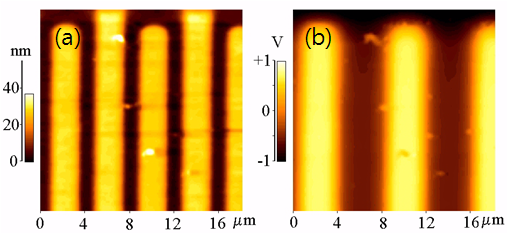
<그림 7> 동작 중인 전자 소자의 형상 (a) 및 EFM (b) 영상

여기서 Vapp는 탐침과 시료 사이에 인가된 전위차이며, Φ는 시료와 탐침의 물질 차이에 의한 일함수 또는 시료의 표면 전위에 해당된다. EFM 신호 추출은 인가된 교류 전압에 의해 진동하는 정전기력 Fw 성분을 Lock-in 증폭기로 측정하면 가능하다. 위의 수식에서 인가된 dc 전위가 영이거나 일정한 경우, Fw 크기는 시료의 전위 Φ에만 의존한다. 따라서 Fw 의 크기는 표면의 상대적인 일함수 또는 표면 전위 차이를 나타낸다. 이 경우엔 상대적인 전위는 알 수 있지만 절대적인 전위차는 알 수 없다. 특별히 Vdc = Φ인 경우에, Fw =0 가 되다. 이러한 특수한 조간을 만족하는 경우를 KFM(Kelvin Force Microscope)라 한다. 따라서 KFM 모드에서는 Vdc = Φ 조건을 만족시킬 수 있는 추가적인 역되먹임이 필요하다. KFM 모드에서는 시료의 전위변화에 따라 탐침의 전위를 동일하게 유지하는 역되먹임 제어가 작동하므로 탐침이 받는 전정기력을 상쇄한다(Fw =0). 이러한 평형 상태에서는 탐침과 시료는 동일한 전위를 가진다는 것을 의미한다(Vdc = Φ). 따라서 탐침에 역되먹임 되는 전압(Vdc) 데이터를 취하면 시료 표면의 절대 전위(Φ)를 알아낼 수 있다.
3-3. SPM 기반 나노리쏘그라피
목공이나 판화에 사용되는 칼, 만년필의 팬, 잉크젯 프린트의 노즐과 같은 역할을 하는 나노 탐침은 나노 세계를 직접 조작하고 정보를 저장, 판독, 인쇄할 수 있는 기능을 갖고 있다. 이러한 기술은 나노 탐침에서 방출되는 근접장의 강도를 조절함으로써 시료의 국소 영역의 형상과 물리적 성질을 변화시킬 수 있으며, SPM 기반 나노 리쏘그라피(Scanning Probe Lithography)라 부른다. 대표적인 SPM 기반 SPL 기법에는 1) 전류를 이용한 산화법, 저에너지/고밀도 전자빔 리쏘그라피, 2) 힘을 이용한 indentation, 3) 확산을 이용한 dip-pen, 4) 전기장을 가하여 전기적 특성을 변화시키는 방법, 4) 열을 이용하여 형상을 변형하는 방법, 5) 근접광을 이용한 방법 등 다양한 기법이 있다. 탐침 주사 방식에 따라서는 라스트 스캔 방식과 벡터 스캔 방식으로 나뉜다. 사진처럼 픽셀 단위로 정교한 패튼 형성을 목적으로 하는 경우에는 라스트 스캔 방식이 적합하며, 도형과 같이 정형화된 패튼 제작에는 벡터 스캔 방식이 더 효율적이다. SPL 기술은 기존의 리쏘그라피 기술로 극복하기 어려운 미세 조작/제작 분야에 독립적으로 적용될 수 있을 뿐 더러 기존 광학, 전자빔 리쏘그라피 기술, lift-off 공정 등과의 접목도 가능하다. 또한 저에너지 고밀도 전자빔 SPL 기술은 기존 고에너지 저밀도 전자빔 리쏘그라피에서 발생하는 proximity 효과를 줄일 수 있어 50nm 이하 나노 양자소자 제작에 활용될 수 있을 것으로 기대된다. SPM은 실험실에서 비교적 저렴하고 간단한 환경 구성으로 나노 세계를 직접 관측하고 조작하는데 매우 적합한 도구며, 특히 대학원이나 학부 과정에서 활용이 가능하며, SPL 기술은 향후 나노 프린팅, 나노 저장장치, 상온 나노 양자소자, 바이오 소자 제작, 단분자 조작 분야에 파급효과가 클 것으로 기대된다.
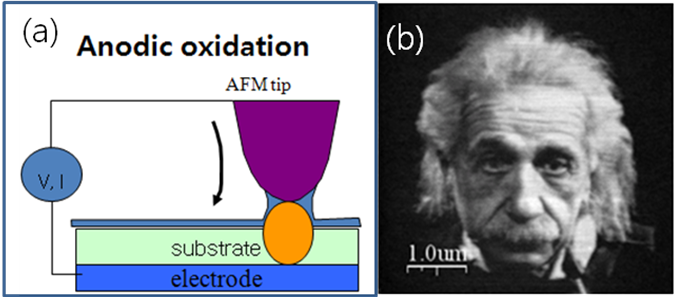
<그림 8> (a) 전류 산화법을 이용한 SPL 기술 개념도
(b) 전류 산화법을 이용한 SPL 수행 결과( 라스트 리쏘그라피 )
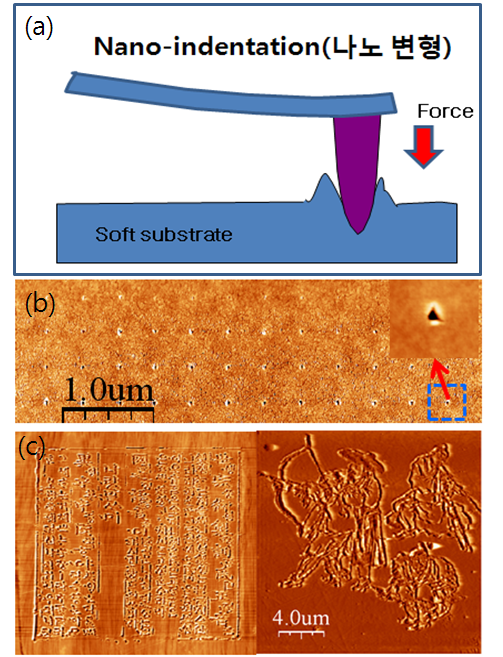
<그림 9> (a) 인덴테이션을 이용한 나노 리쏘그라피 개념도, (b) 벡터 방식을 이용한 인덴테이션 리쏘그라피 결과
(c) 라스트 방식을 이용한 인덴테이션 리쏘그라피 결과
4.개발 동향 및 향후 전망
SPM은 원자, 분자 수준의 분해능을 갖는 표면 분석 장비로 미세 구조, 전자기적, 기계적 특성 분석에 널리 활용되고 있으며 최근 20년간 나노기술을 선도해 왔다. 하지만 기술적인 측면에서 SPM의 가장 큰 단점은 측정 속도가 느리고 타 현미경에 비해 사용법이 복잡하다는 것이다. 이러한 단점은 SPM이 산업 분야에 활용되는데 가장 큰 장해물이었다. 하지만 최근 속도를 획기적으로 개선할 수 있는 고속 AFM 기술이 개발되고 있으며, 비디오 수준의 속도를 제공하는 실시간 AFM 기술이 개발되고 있다. 또한 SPM 동작에 필요한 많은 작업과 파라미터 튜닝을 컴퓨터로 자동화하여 쉽게 사용할 수 있도록 개발되고 있다.
한편, 나노 영역에서 일어나는 복잡한 현상을 이해하는데 SPM 분석만으로는 한계가 있다. 과거 20년간 SPM 기술 개발은 성능 개선과 다양한 응용 모드개발에 주안점을 두었지만, 최근에는 타 기술과 기능적 결합을 통한 융합화 방향으로 제품 개발이 전개되는 추세이다. 대표적인 예로, SPM과 광학 기술의 융합, SPM과 전자빔 기술을 융합을 들 수 있으며, 융합기술은 단순한 기능적 확장을 넘어 개별 기술의 단점을 보완하고 기술적 한계 극복하여 응용 가치를 극대화 할 수 있다. 이러한 융합 장비는 단일 장비로는 불가능한 다중 측정, in-situ 측정, 종합적 분석을 가능하게 함으로써 활용 분야가 매우 광범위할 것으로 예상된다. 특히, SPM 기술과 광학현미경, 분광기술을 융합한 기술은 신소재, 반도체 소자 결함 및 응력 측정, 바이오 분야에서 화학적 성분 분석/분자 검출에 매우 중요한 기술로 평가되며 기술의 파급효과는 매우 클 것으로 전망된다.
***** SPM (suspended particulate matter)
'과학 이야기' 카테고리의 다른 글
| 하늘을 나는 자동차 / YTN뉴스 (0) | 2013.08.08 |
|---|---|
| 동물과 미물들의 지혜 (0) | 2013.07.11 |
| 유기박막 필름 전자장치 성능 개선 (0) | 2013.07.10 |
| 유기 박막 트랜지스터 개발 연구 협력 (0) | 2013.07.10 |
| 유기적 센서 / 후지와 파나소닉 공동개발 (0) | 2013.07.10 |